バーティカルチップボンディング例
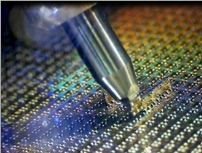


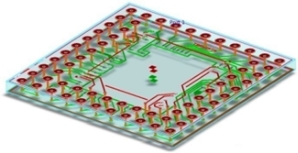

Vertical Flip Chip Bonding
プロセス例(バーティカルチップアセンブリー)

バーティカル ボンディング プロセスフロー

Flip Chip実装用装置:LAPLACE-FC
- 消費エネルギーや発熱を削減
- 小パッケージ化や新たな実装構造を実現
- 光通信デバイスのような複雑な構造にも対応
- 光信号から電気信号への変換を短距離で実現
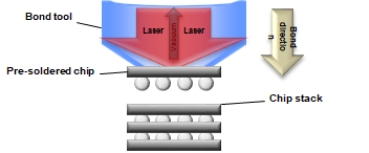



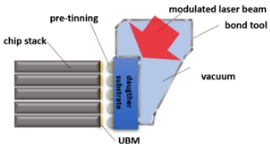

Flip Chip実装用装置:LAPLACE-FC
アプリケーション:Chipのリワーク
- Laserによる局所加熱と吸引により選択的にChip回収が可能
- さらに局所的に実装&リフロー可能
- ハイエンドWafer Level Pavkage:Fan Out、Embedded、WLCSP など
- 不良Chipのリワーク (回収&実装)


Flip Chip実装用装置:LAPLACE-FC
アプリケーション:極小チップ~大チップ
Ultra Small Die Pick-and-Place
and placement on LTCC
(0.35 x 0.55mm die size)
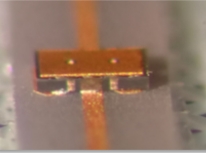
stand-off bump height
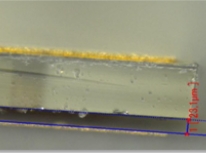
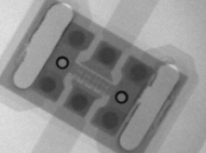
Large Die Placement and In-situ Reflow
(30µm Cu pillar)
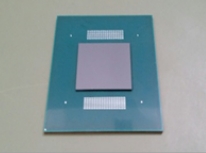


Flip Chip実装用装置:LAPLACE-FC
アプリケーション:極小チップ~大チップ
キャパシタ実装



強固なハンダ接合

Surface Mount Technology用装置:LAPLACE-Cap
アプリケーションとデバイス:Probe Card
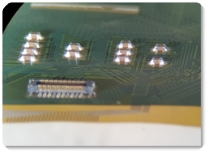
(キャパシタとコネクタ拡大)

(キャパシタとコネクタ拡大)
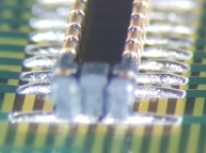
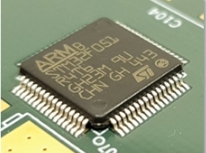
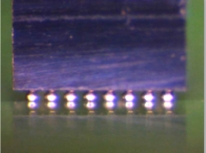

Surface Mount Technology用装置:LAPLACE-Can
アプリケーションとデバイス

(ピッチ:80μm)
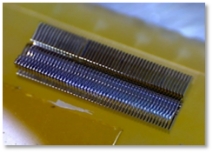
垂直実装用装置:LAPLACE-VC
コンセプトとアプリケーション

LAPLACEのカスタム対応
アプリケーション
- ギ酸(Formin acid)によりフラックスレス実装可能
- 様々な雰囲気設定が可能(活性ガス、不活性ガス、真空 など)
- セルフアライメントにより高い実装精度が可能
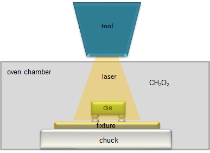
LAPLACEのカスタム対応
- Capillaryでピンを固定
- Solder上のピンを直接Laserで加熱
- Capillaryの隙間からN2ガスを断続的に供給
- フラックスレス実装