Single Layer (Positive type):NPR9730T
Features
Positive resist for lift-off process.
Exposure wavelength range: g-line to i-line (broadband compatible).
Easy formation of anti tapered shapes without special processes
Good peelability.
Film thickness, line width, shape, etc. can be proposed according to the customer's requirements.
| Process | Conditions |
|---|---|
| substrate | 5-inch Si Wafer |
| pre-treatment | HMDS |
| Coating method | Spin coating |
| Prebake | 90℃, 120s, Hot plate |
Coating Sequense
Example.) NPR-9730T 60mPa・s

Spin curve
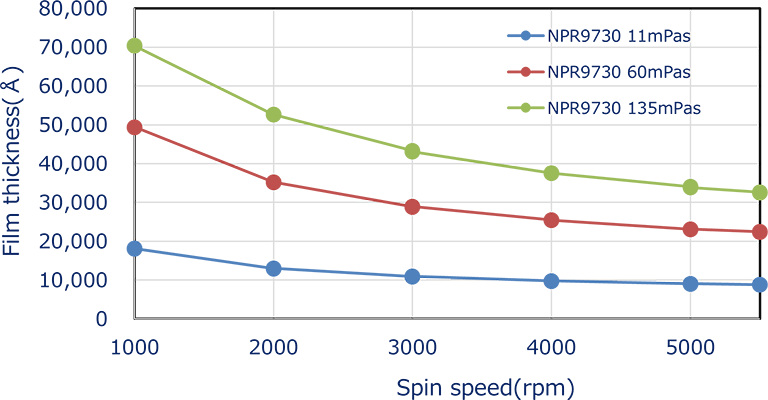
Film Thickness Uniformity
Product; NPR9730T(60mPa・s)
Process condition
Substrate; 5inch Si wafer
Spin speed; 1,020rpm
Pre-bake; 90℃, 120s, hotplate

Measurement condition of film thickness
13 columns x 13 lines = 169 points
pitch of each point = 5mm

Exposure margin
| Dose | 55mJ/cm2 | 60mJ/cm2 | 65mJ/cm2 |
|---|---|---|---|
| NPR9730T | 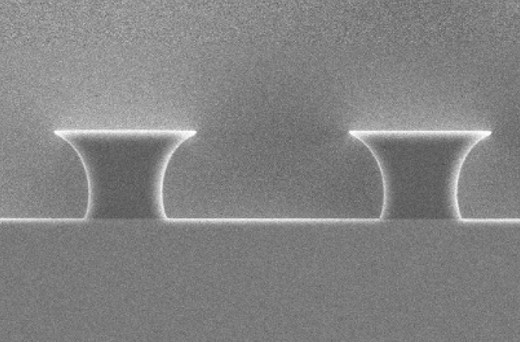 |
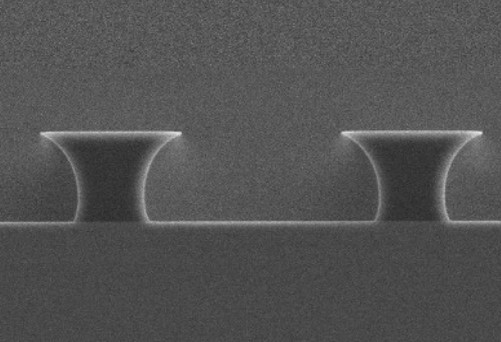 |
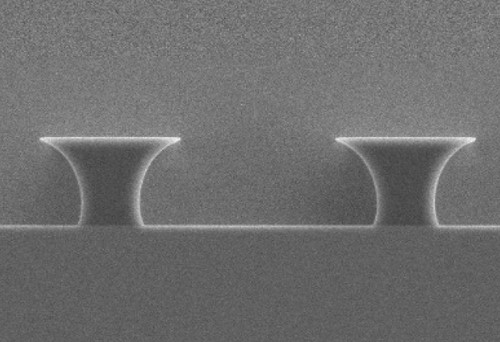 |
【Process conditions】
- Substrate
- 5-inchs Bare-Si
- Coating
- Spin coat
- Prebake
- 90℃, 120s, Hot plate
- Thickness
- 3μm
- Exposure
- NSR-TFHi12, i-line stepper, NA=0.45, σ=0.6
- PEB
- Not applied
- Development
- 2.38% TMAH, 23℃, 60s, Single Puddle
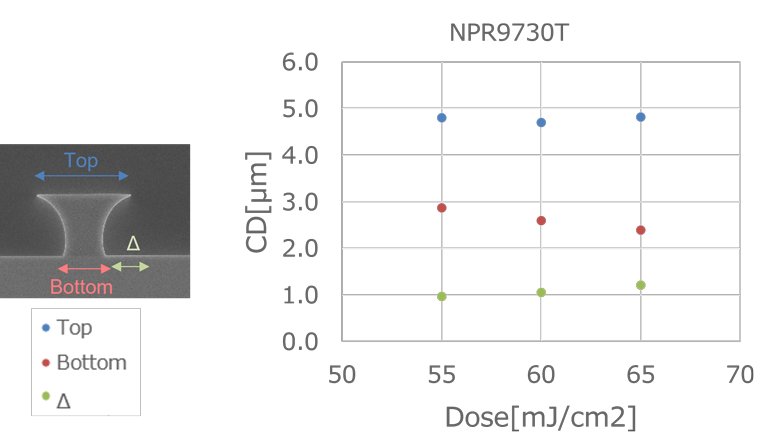
Focus margin
| Focus | -3μm | 0μm | 3μm |
|---|---|---|---|
| NPR9730T | 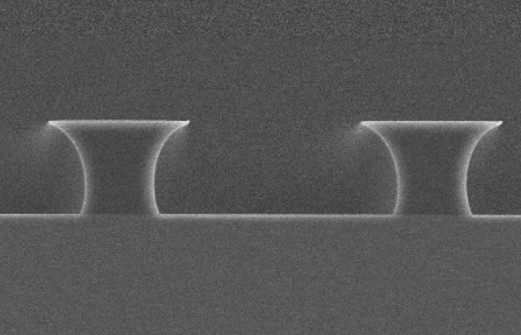 |
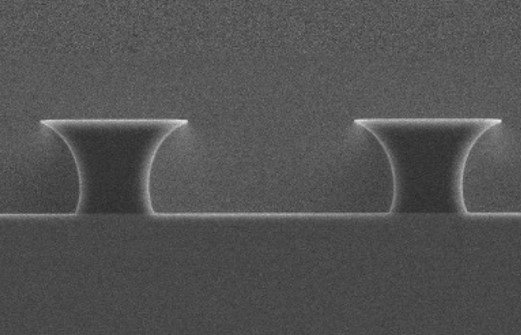 |
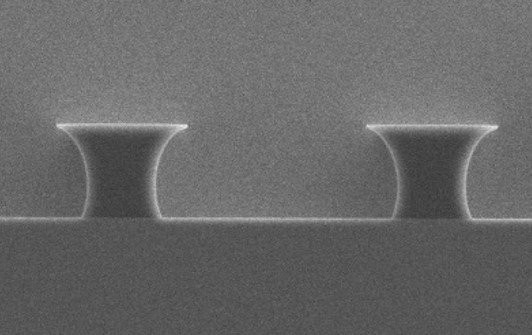 |
【Process conditions】
- Substrate
- 5-inchs Bare-Si
- Coating
- Spin coat
- Prebake
- 90℃, 120s, Hot plate
- Thickness
- 3μm
- Exposure
- NSR-TFHi12, i-line stepper, NA=0.45, σ=0.6
- PEB
- Not applied
- Development
- 2.38% TMAH, 23℃, 60s, Single Puddle

Development margin
| Development time | 55s | 60s | 65s |
|---|---|---|---|
| NPR9730T | 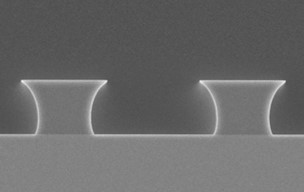 |
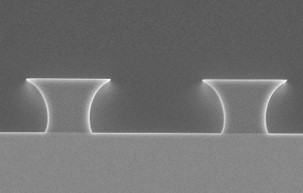 |
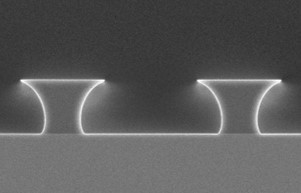 |
【Process conditions】
- Substrate
- 5-inchs Bare-Si
- Coating
- Spin coat
- Prebake
- 90℃, 120s, Hot plate
- Thickness
- 3μm
- Exposure
- NSR-TFHi12, i-line stepper, NA=0.45, σ=0.6
- PEB
- Not applied
- Development
- 2.38% TMAH, 23℃, 55, 60, 65s, Single Puddle
Contact angle of DIW and developer on PR film
Process condition
Substrate; 5inch Si wafer
Spin speed; 1,020rpm
Pre-bake; 90℃, 120s, hotplate
Measurement of contact angle
Dropping liquid on PR film; DIW, 2.38% TMAH
Waiting time from dropping to measurement of contact angle; 60s

| Product | Contact angle(°) | |
|---|---|---|
| DIW | 2.38%TMAH | |
| NPR9730T | 89.6 | 82.2 |
Photosensitivity and Dark erosion
Process condition
Substrate; 5inch Si wafer
Spin speed; 1,020rpm
Pre-bake; 90℃, 120s, hotplate
| Product | Film thickness(Å) | Dark erosion (Å) |
Eth (mJ/cm2) |
|
|---|---|---|---|---|
| after pre-bake |
after development |
|||
| NPR9730T | 50125 | 50644 | +519*1 | 56.5 |
*1 The dehydration bake wasn’t applied to PR film after development process.